
-

生物通官微
陪你抓住生命科技
跳动的脉搏
复杂三维物体表面原子层沉积均匀薄膜的边界层调控新策略及其等离子体抗蚀性能研究
【字体: 大 中 小 】 时间:2025年06月18日 来源:National Science Review 16.3
编辑推荐:
本研究针对复杂3D物体表面原子层沉积(ALD)薄膜均匀性差、前驱体利用率低的难题,创新性提出通过狭缝挡板调控边界层前驱体浓度的解决方案。通过计算流体动力学模拟优化挡板参数,将Al2 O3 薄膜厚度不均匀性从35.46%降至5.75%,前驱体利用率提升7%,等离子体刻蚀速率降低至1.11 nm min-1 ,为半导体设备关键部件防护涂层提供了新思路。
随着集成电路技术向更小节点发展,半导体制造设备中金属部件的等离子体刻蚀防护成为关键挑战。氟基等离子体在刻蚀过程中会侵蚀反应腔体内的金属部件,产生颗粒污染物,不仅降低设备性能还会污染晶圆。传统热喷涂技术如大气等离子喷涂(APS)虽能制备Y2
O3
等抗蚀涂层,但难以覆盖复杂三维结构。原子层沉积(ALD)因其自限制生长特性,理论上可在高深宽比结构表面形成保形薄膜,但实际应用中面临两大瓶颈:复杂几何表面薄膜均匀性差(厚度不均匀性达35.46%),以及前驱体利用率低(约69.55%)。这些问题严重制约了ALD技术在半导体设备关键部件(如淋浴头结构)防护涂层中的应用。
为解决这一难题,天津大学的研究团队在《National Science Review》发表研究,创新性地提出通过设计狭缝挡板调控边界层前驱体浓度的新策略。该研究通过计算流体动力学模拟优化挡板参数,实验证明优化后的挡板组合可将Al2
O3
薄膜厚度不均匀性从35.46%降至5.75%,前驱体利用率提升至74.45%,更使等离子体刻蚀速率从5.19 nm min-1
降至1.11 nm min-1
,展现出优异的抗蚀性能。这一成果不仅为半导体设备关键部件提供了可靠的防护方案,更为复杂三维物体表面ALD工艺优化提供了普适性设计原则。
关键技术方法包括:1)定制化ALD反应腔体设计(350×200×200 mm)与复杂3D样品(Φ165-20 mm圆盘+Φ25-80 mm柱体)制备;2)基于计算流体动力学(CFD)的多物理场耦合模拟(流体传输、传热、传质及表面反应);3)采用椭偏仪测量薄膜厚度与折射率,场发射扫描电镜(SEM)表征形貌;4)ICP-CCP系统进行氟等离子体刻蚀测试(CF4
/O2
/Ar=30/5/10 sccm,400 W ICP功率);5)电化学测试(极化曲线与阻抗谱)评估抗腐蚀性能。
RESULTS AND DISCUSSION
边界层调控机制:通过引入A、B、C三块挡板形成10 mm狭缝间隙,使边界层厚度与狭缝间隙比达43.85%,显著提升前驱体(TMA)在表面边界层的浓度。模拟显示表面-OH覆盖率从0.35降至接近0,表明前驱体吸附充分。
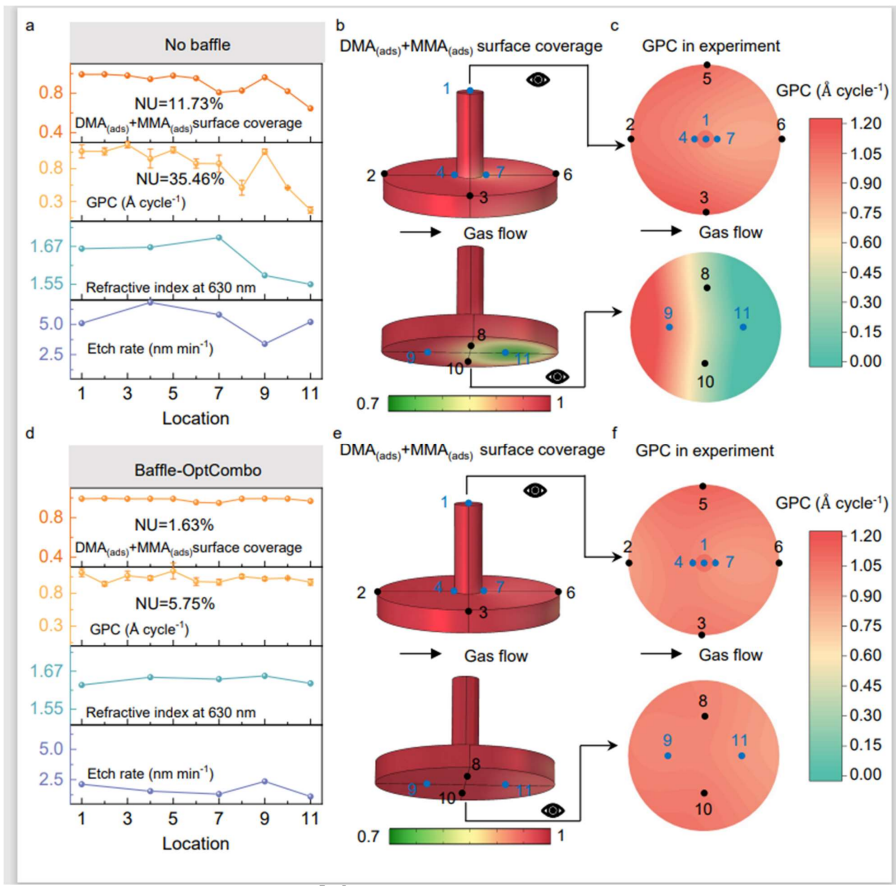
工艺优化:添加P挡板(形状1,h=140 mm)后,吹扫时间从12.8 s缩短至9.7 s,前驱体暴露量从7500 Pa・s提升至优化后的水平,且不影响表面反应。
性能验证:实验测得薄膜厚度不均匀性从35.46%降至5.75%,折射率分布均匀(1.63-1.65),AFM显示表面粗糙度Ra
从1.4 nm降至0.628 nm。等离子体刻蚀测试表明,理想ALD生长的Al2
O3
刻蚀速率(1.11 nm min-1
)仅为非理想薄膜的1/5,电化学测试显示腐蚀电流密度降低一个数量级。
CONCLUSION
该研究通过创新性挡板设计实现了复杂3D物体表面ALD工艺的三大突破:1)建立边界层厚度/狭缝间隙比与薄膜均匀性的定量关系;2)开发出可兼顾前驱体利用率(74.45%)与吹扫效率(9.7 s)的挡板组合;3)证实理想ALD生长的Al2
O3
具有最优抗等离子体刻蚀性能(1.11 nm min-1
)。这项成果不仅解决了半导体设备关键部件的防护难题,其"通过局部流体调控优化表面反应"的核心思想,还可推广至其他需要复杂三维表面改性的领域,如航天器原子氧防护涂层、微机电系统封装等,具有重要的工业应用价值。
 生物通微信公众号
生物通微信公众号
知名企业招聘